
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Mainstream Debonding Paraan
Sa pagsulong ng pagproseso ng semiconductor at tumataas na pangangailangan para sa mga elektronikong sangkap, ang paggamit ng mga ultra-manipis na wafer (kapal na mas mababa sa 100 micrometers) ay naging lalong kritikal. Gayunpaman, sa patuloy na pagbabawas sa kapal ng wafer, ang mga wafer ay lubhang madaling masira sa mga kasunod na proseso, tulad ng paggiling, pag-ukit, at metalisasyon.
Ang mga pansamantalang teknolohiya sa pagbubuklod at pag-debonding ay karaniwang ginagamit upang magarantiya ang matatag na pagganap at produksyon ng mga semiconductor na aparato. Ang ultra-manipis na wafer ay pansamantalang naayos sa isang matibay na substrate ng carrier, at pagkatapos ng pagproseso sa likod, ang dalawa ay pinaghihiwalay. Ang proseso ng paghihiwalay na ito ay kilala bilang debonding, na pangunahing kinabibilangan ng thermal debonding, laser debonding, chemical debonding, at mechanical debonding.
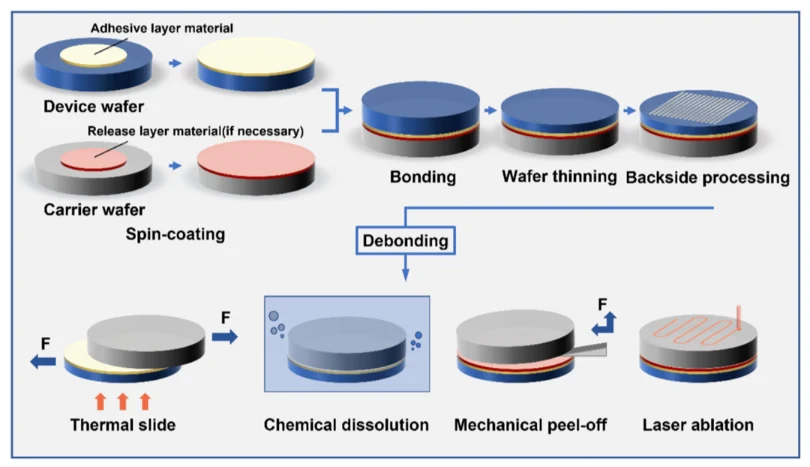
Thermal Debonding
Ang thermal debonding ay isang paraan na naghihiwalay sa mga ultra-manipis na wafer mula sa mga substrate ng carrier sa pamamagitan ng pag-init upang mapahina at mabulok ang bonding adhesive, at sa gayon ay nawawala ang adhesiveness nito. Pangunahing nahahati ito sa thermal slide debonding at thermal decomposition debonding.
Karaniwang kinabibilangan ng thermal slide debonding ang pag-init ng mga bonded na wafer sa temperatura ng paglambot ng mga ito, na humigit-kumulang mula 190°C hanggang 220°C. Sa ganitong temperatura, nawawalan ng adhesive ang bonding adhesive, at ang mga ultra-manipis na wafer ay maaaring dahan-dahang itulak o ma-peel off ang mga substrate ng carrier sa pamamagitan ng shearing force na inilapat ng mga device gaya ngmga vacuum chuckupang makamit ang maayos na paghihiwalay. Habang nasa thermal decomposition debonding, ang mga bonded wafer ay pinainit sa mas mataas na temperatura, na nagiging sanhi ng chemical decomposition (molecular chain scission) ng adhesive at tuluyang nawawala ang pagdirikit nito. Bilang resulta, ang mga bonded wafer ay maaaring natural na matanggal nang walang anumang mekanikal na puwersa.
Laser debonding
Ang laser debonding ay isang paraan ng debonding na gumagamit ng laser irradiation sa adhesive layer ng bonded wafers. Ang malagkit na layer ay sumisipsip ng enerhiya ng laser at bumubuo ng init, sa gayon ay sumasailalim sa isang photolytic reaksyon. Ang diskarte na ito ay nagbibigay-daan sa paghihiwalay ng mga ultra-manipis na wafer mula sa mga substrate ng carrier sa temperatura ng silid o medyo mababa ang temperatura.
Gayunpaman, ang isang mahalagang kinakailangan para sa laser debonding ay ang carrier substrate ay dapat na transparent sa laser wavelength na ginamit. Sa ganitong paraan, ang enerhiya ng laser ay maaaring matagumpay na tumagos sa substrate ng carrier at epektibong hinihigop ng materyal ng bonding layer. Para sa kadahilanang ito, ang pagpili ng laser wavelength ay kritikal. Kasama sa mga karaniwang wavelength ang 248 nm at 365 nm, na dapat itugma sa mga katangian ng optical absorption ng bonding material.
Chemical Debonding
Nakakamit ng chemical debonding ang mga paghihiwalay ng bonded wafers sa pamamagitan ng pagtunaw ng bonding adhesive layer na may nakalaang kemikal na solvent. Nangangailangan ang prosesong ito ng mga solvent na molekula na tumatagos sa adhesive layer upang maging sanhi ng pamamaga, pagputol ng chain, at tuluyang pagkalusaw, na nagpapahintulot sa mga ultra-manipis na wafer at carrier substrate na natural na maghiwalay. Samakatuwid, walang karagdagang kagamitan sa pag-init o mekanikal na puwersa na ibinigay ng mga vacuum chuck ang kinakailangan, ang chemical debonding ay nagdudulot ng kaunting stress sa mga wafer.
Sa pamamaraang ito, ang mga wafer ng carrier ay madalas na na-pre-drill upang payagan ang solvent na ganap na makontak at matunaw ang bonding layer. Ang kapal ng malagkit ay nakakaapekto sa kahusayan at pagkakapareho ng pagpasok at pagkalusaw ng solvent. Ang mga natutunaw na bonding adhesive ay kadalasang thermoplastic o binagong polyimide-based na materyales, kadalasang inilalapat sa pamamagitan ng spin-coating.
Mechanical Debonding
Ang mekanikal na debonding ay naghihiwalay ng mga ultra-manipis na wafer mula sa mga pansamantalang carrier substrates ng eksklusibo sa pamamagitan ng paglalapat ng kontroladong mekanikal na puwersa ng pagbabalat, nang walang init, mga kemikal na solvent, o mga laser. Ang proseso ay katulad ng pagbabalat ng tape, kung saan ang wafer ay dahan-dahang "tinataas" sa pamamagitan ng precision mechanical operation.
Nag-aalok ang Semicorex ng mataas na kalidadSIC Porous Ceramic Debonding Chucks. Kung mayroon kang anumang mga katanungan o kailangan ng karagdagang mga detalye, mangyaring huwag mag-atubiling makipag-ugnayan sa amin.
Makipag-ugnayan sa telepono # +86-13567891907
Email: sales@semicorex.com




