
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Paglinsad sa mga kristal ng SiC
Maaaring magkaroon ng mga microscopic na depekto ang substrate ng SiC, gaya ng Threading Screw Dislocation (TSD), Threading Edge Dislocation (TED), Base Plane Dislocation (BPD), at iba pa. Ang mga depektong ito ay sanhi ng mga paglihis sa pag-aayos ng mga atomo sa antas ng atom.
Ang mga kristal ng SiC ay karaniwang lumalaki sa paraang umaabot parallel sa c-axis o sa isang maliit na anggulo dito, na nangangahulugan na ang c-plane ay kilala rin bilang base plane. Mayroong dalawang pangunahing uri ng mga dislokasyon sa kristal. Kapag ang linya ng dislokasyon ay patayo sa base plane, ang kristal ay namamana ng mga dislokasyon mula sa seed crystal patungo sa epitaxial grown crystal. Ang mga dislocation na ito ay kilala bilang penetrating dislocations at maaaring ikategorya sa threading edge dislocations(TED) at threading screw dislocations(TSD) batay sa oryentasyon ng Bernoulli vector sa dislocation line. Ang mga dislokasyon, kung saan ang parehong mga linya ng dislokasyon at ang mga Brönsted vector ay nasa base plane, ay tinatawag na base plane dislocations (BPD). Ang mga kristal ng SiC ay maaari ding magkaroon ng mga pinagsama-samang dislokasyon, na isang kumbinasyon ng mga dislokasyon sa itaas.
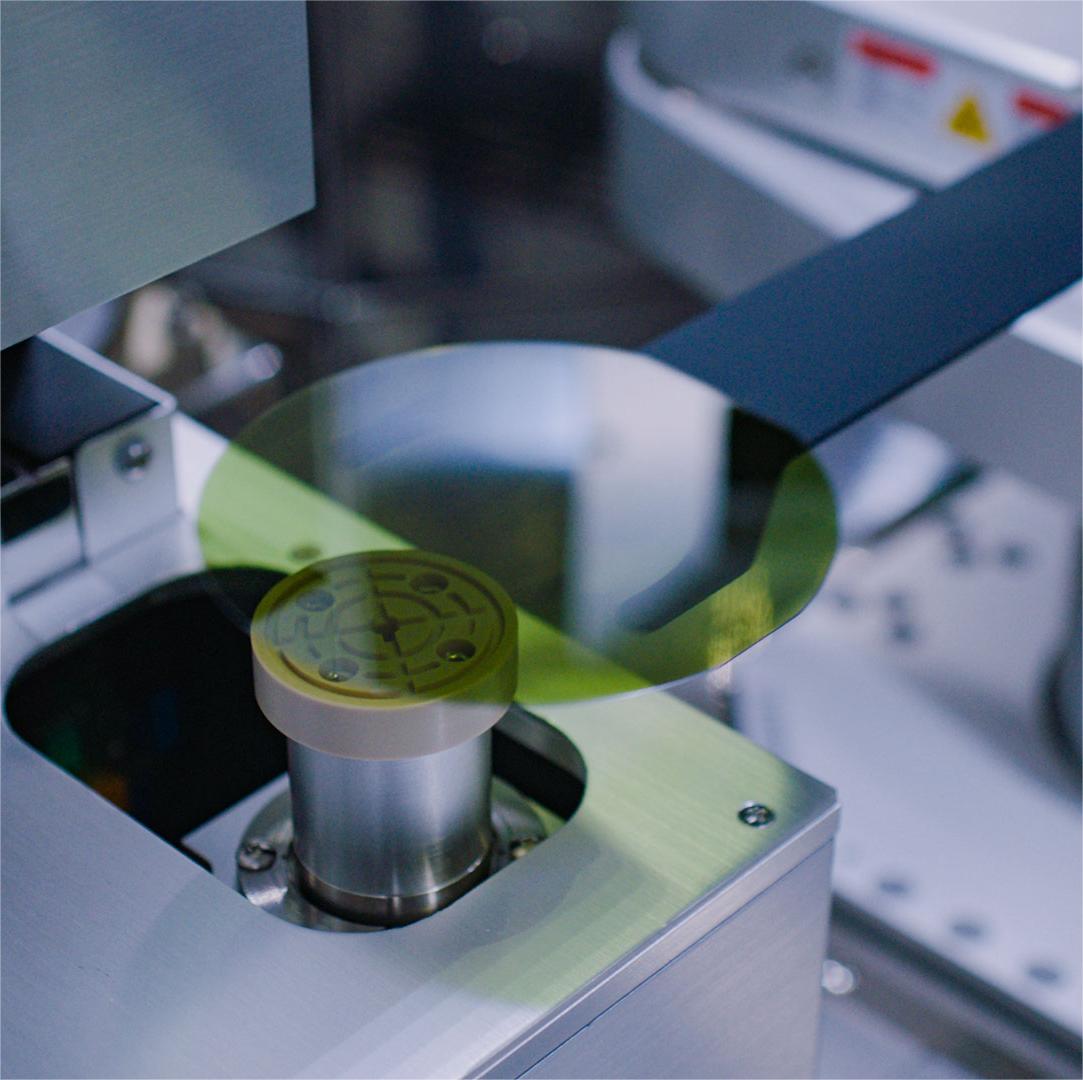
1. TED&TSD
Parehong threaded dislocations (TSDs) at threaded edge dislocations (TEDs) ay tumatakbo kasama ang [0001] growth axis na may iba't ibang Burgers vectors na <0001> at 1/3<11-20>, ayon sa pagkakabanggit.
Ang parehong mga TSD at TED ay maaaring umabot mula sa substrate hanggang sa ibabaw ng wafer at makagawa ng mga maliliit na katangian sa ibabaw na parang hukay. Karaniwan, ang density ng mga TED ay humigit-kumulang 8,000-10,000 1/cm2, na halos 10 beses kaysa sa mga TSD.
Sa panahon ng proseso ng paglago ng SiC epitaxial, ang TSD ay umaabot mula sa substrate hanggang sa epitaxial layer ng pinalawig na TSD ay maaaring mag-transform sa iba pang mga depekto sa substrate plane at magpalaganap sa kahabaan ng growth axis.
Ipinakita na sa panahon ng paglago ng SiC epitaxial, ang TSD ay binago sa stacking layer faults (SF) o mga depekto sa karot sa substrate plane, habang ang TED sa epitaxial layer ay ipinapakita na binago mula sa BPD na minana mula sa substrate sa panahon ng paglaki ng epitaxial.
2. BPD
Ang mga basal plane dislocations (BPDs), na matatagpuan sa [0001] plane ng SiC crystals, ay may Burgers vector na 1/3 <11-20>.
Ang mga BPD ay bihirang lumitaw sa ibabaw ng SiC wafers. Ang mga ito ay karaniwang puro sa substrate sa density na 1500 1/cm2, habang ang kanilang density sa epitaxial layer ay halos 10 1/cm2 lamang.
Nauunawaan na ang density ng BPD ay bumababa sa pagtaas ng kapal ng SiC substrate. Kapag sinuri gamit ang photoluminescence (PL), ang mga BPD ay nagpapakita ng mga linear na tampok. Sa panahon ng proseso ng paglago ng SiC epitaxial, ang pinalawig na BPD ay maaaring mabago sa SF o TED.
Mula sa itaas, maliwanag na ang mga depekto ay naroroon sa SiC substrate wafer. Ang mga depektong ito ay maaaring mamana sa epitaxial growth ng mga manipis na pelikula, na maaaring magdulot ng nakamamatay na pinsala sa SiC device. Ito ay maaaring humantong sa pagkawala ng mga pakinabang ng SiC tulad ng mataas na breakdown field, mataas na reverse voltage, at mababang leakage current. Higit pa rito, maaari nitong bawasan ang rate ng kwalipikasyon ng produkto at magdulot ng malalaking hadlang sa industriyalisasyon ng SiC dahil sa nabawasan na pagiging maaasahan.




