
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe sa Chip Manufacturing: Isang Propesyonal na Ulat sa Balita
Ang Ebolusyon ng Mga Materyal na Semiconductor
Sa larangan ng modernong teknolohiyang semiconductor, ang walang humpay na pagmamaneho patungo sa miniaturization ay nagtulak sa mga limitasyon ng tradisyonal na mga materyales na nakabatay sa silikon. Upang matugunan ang mga pangangailangan para sa mataas na pagganap at mababang paggamit ng kuryente, ang SiGe (Silicon Germanium) ay lumitaw bilang isang pinagsama-samang materyal na pinili sa paggawa ng semiconductor chip dahil sa kakaibang pisikal at elektrikal na katangian nito. Ang artikulong ito ay sumasalamin saproseso ng epitaxyng SiGe at ang papel nito sa paglaki ng epitaxial, mga pilit na aplikasyon ng silikon, at mga istruktura ng Gate-All-Around (GAA).
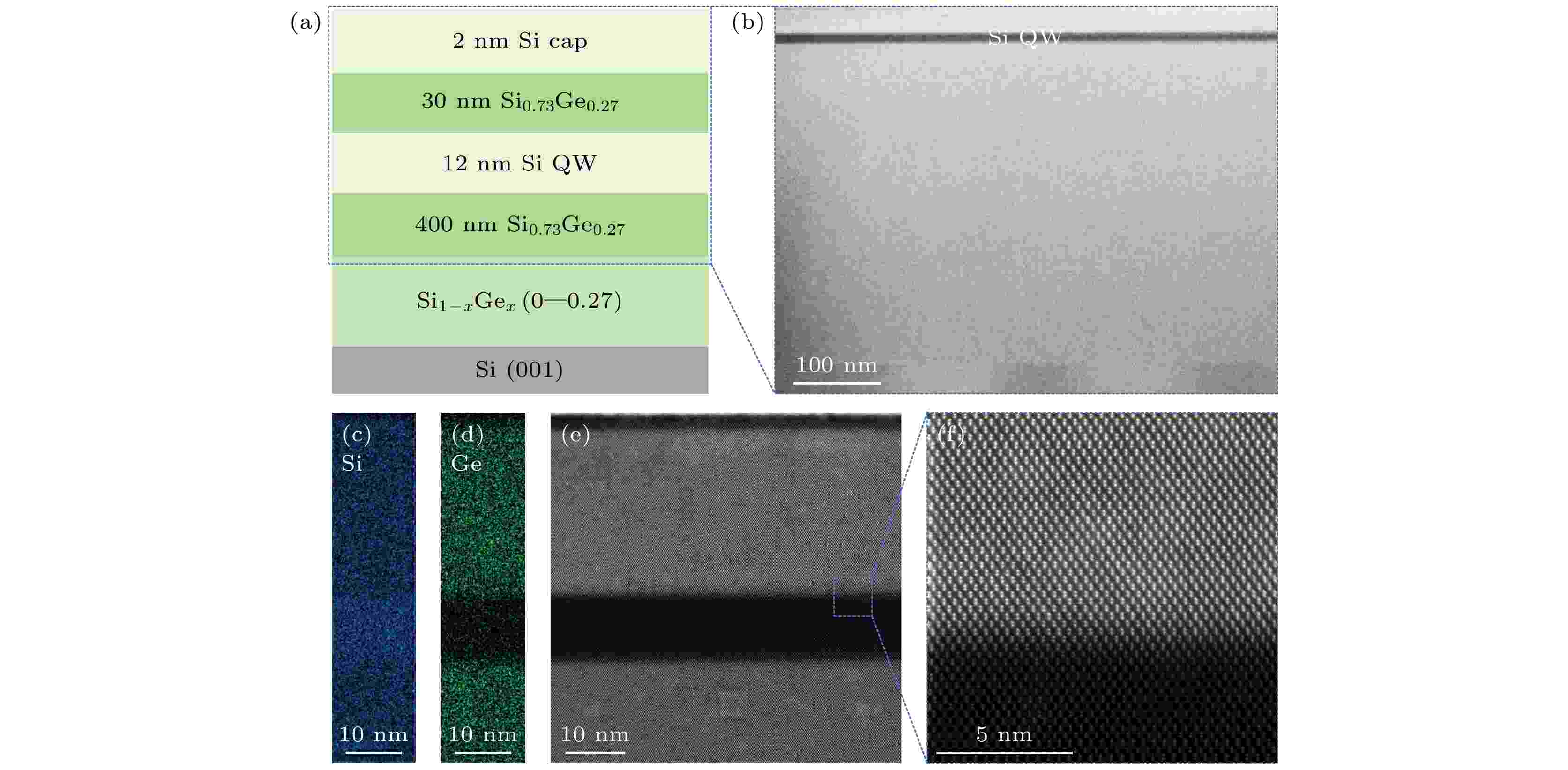
Ang Kahalagahan ng SiGe Epitaxy
1.1 Panimula sa Epitaxy sa Paggawa ng Chip:
Ang epitaxy, na madalas na dinaglat bilang Epi, ay tumutukoy sa paglaki ng isang solong kristal na layer sa isang solong kristal na substrate na may parehong pagsasaayos ng sala-sala. Ang layer na ito ay maaaring alinmanhomoepitaxial (tulad ng Si/Si)o heteroepitaxial (tulad ng SiGe/Si o SiC/Si). Iba't ibang paraan ang ginagamit para sa epitaxial growth, kabilang ang Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmospheric at Reduced Pressure Epitaxy (ATM & RP Epi). Nakatuon ang artikulong ito sa mga proseso ng epitaxy ng silicon (Si) at silicon-germanium (SiGe) na malawakang ginagamit sa produksyon ng semiconductor integrated circuit na may silikon bilang materyal na substrate.
1.2 Mga Bentahe ng SiGe Epitaxy:
Ang pagsasama ng isang tiyak na proporsyon ng germanium (Ge) sa panahon ngproseso ng epitaxybumubuo ng SiGe single-crystal layer na hindi lamang nagpapababa sa lapad ng bandgap ngunit pinapataas din ang cut-off frequency (fT) ng transistor. Ginagawa nitong malawakang naaangkop sa mga high-frequency na device para sa mga wireless at optical na komunikasyon. Bukod dito, sa mga advanced na proseso ng integrated circuit ng CMOS, ang mismatch ng sala-sala (mga 4%) sa pagitan ng Ge at Si ay nagpapakilala ng stress ng lattice, na nagpapahusay sa mobility ng mga electron o butas at sa gayon ay pinapataas ang saturation current at bilis ng pagtugon ng device.

Ang Komprehensibong Daloy ng Proseso ng SiGe Epitaxy
2.1 Pre-treatment:
Ang mga silicone wafer ay paunang ginagamot batay sa nais na mga resulta ng proseso, pangunahin na kinasasangkutan ng pag-alis ng natural na layer ng oxide at mga dumi sa ibabaw ng wafer. Para sa mabigat na doped na substrate wafer, mahalagang isaalang-alang kung kinakailangan ang backsealing upang mabawasan ang auto-doping sa mga susunod napaglaki ng epitaxy.
2.2 Mga Gas at Kundisyon ng Paglago:
Mga silikon na gas: Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), at Trichlorosilane (TCS, SiHCl₃) ay ang tatlong pinakakaraniwang ginagamit na pinagmumulan ng silicon gas. Ang SiH₄ ay angkop para sa mababang-temperatura na buong proseso ng epitaxy, habang ang TCS, na kilala sa mabilis nitong paglaki, ay malawakang ginagamit para sa paghahanda ng makapal.silikon na epitaxymga layer.
Germanium gas: Ang Germane (GeH₄) ay ang pangunahing pinagmumulan ng pagdaragdag ng germanium, na ginagamit kasama ng mga pinagmumulan ng silikon upang bumuo ng mga SiGe alloy.
Selective epitaxy: Ang selective growth ay nakakamit sa pamamagitan ng pagsasaayos ng relative rate ngepitaxial depositionat in situ etching, gamit ang chlorine-containing silicon gas DCS. Ang selectivity ay dahil sa adsorption ng Cl atoms sa silicon surface na mas mababa kaysa sa oxides o nitride, na nagpapadali sa paglaki ng epitaxial. Ang SiH₄, na kulang sa Cl atoms at may mababang activation energy, ay karaniwang inilalapat lamang sa mababang temperatura na buong proseso ng epitaxy. Ang isa pang karaniwang ginagamit na mapagkukunan ng silikon, ang TCS, ay may mababang presyon ng singaw at likido sa temperatura ng silid, na nangangailangan ng pagbubula ng H₂ upang ipasok ito sa silid ng reaksyon. Gayunpaman, ito ay medyo mura at kadalasang ginagamit para sa mabilis na rate ng paglago nito (hanggang 5 μm/min) upang mapalago ang mas makapal na mga layer ng silicon epitaxy, na malawakang inilapat sa paggawa ng silicon epitaxy wafer.
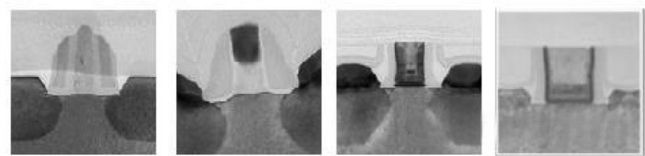
Strained Silicon sa Epitaxial Layers
Sa panahon ngpaglaki ng epitaxial, idineposito ang epitaxial single-crystal Si sa isang nakakarelaks na layer ng SiGe. Dahil sa mismatch ng sala-sala sa pagitan ng Si at SiGe, ang Si single-crystal layer ay sumasailalim sa tensile stress mula sa pinagbabatayan na SiGe layer, na makabuluhang pinahusay ang electron mobility sa NMOS transistors. Hindi lamang pinapataas ng teknolohiyang ito ang saturation current (Idsat) ngunit pinapabuti din nito ang bilis ng pagtugon ng device. Para sa mga PMOS device, ang mga layer ng SiGe ay epitaxially na pinalaki sa mga rehiyon ng pinagmulan at drain pagkatapos ng pag-ukit upang ipasok ang compressive stress sa channel, pagpapahusay ng mobility ng butas at pagtaas ng saturation current.
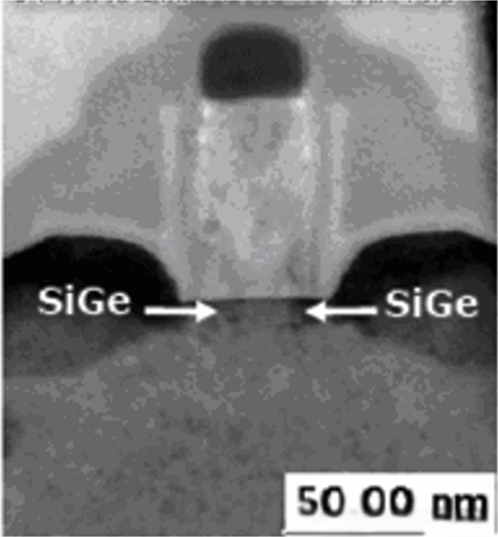
SiGe bilang Sacrificial Layer sa GAA Structures
Sa paggawa ng Gate-All-Around (GAA) nanowire transistors, ang mga layer ng SiGe ay kumikilos bilang mga sacrificial layer. Ang high-selectivity anisotropic etching techniques, gaya ng quasi-atomic layer etching (quasi-ALE), ay nagbibigay-daan para sa tumpak na pag-alis ng mga layer ng SiGe upang bumuo ng mga istruktura ng nanowire o nanosheet.

Kami sa Semicorex ay dalubhasa saMga solusyon sa grapayt na pinahiran ng SiC/TaCinilapat sa Si epitaxial growth sa semiconductor manufacturing, kung mayroon kang anumang mga katanungan o kailangan ng karagdagang mga detalye, mangyaring huwag mag-atubiling makipag-ugnayan sa amin.
Makipag-ugnayan sa telepono: +86-13567891907
Email: sales@semicorex.com




